三星将推出3D AI芯片封装技术SAINT,与台积电竞争
随着芯片尺寸的缩小变得越来越具有挑战性,3D芯片封装技术的竞争变得更加激烈。全球最大的存储器芯片制造商三星电子公司计划明年推出先进的三维(3D)芯片封装技术,与代工巨头台湾半导体制造公司(TSMC)竞争。
本文引用地址://www.cghlg.com/article/202311/452804.htm
总部位于韩国水原的芯片制造商将使用该技术——SAINT,即三星先进互连技术——以更小的尺寸集成高性能芯片(包括AI芯片)所需的内存和处理器。
据知情人士周日透露,三星计划在SAINT品牌下推出三种技术——SAINT S,垂直堆叠SRAM存储芯片和CPU;SAINT D,涉及CPU、GPU和DRAM存储等处理器的垂直封装;SAINT L,堆叠应用处理器(AP)。
目前的2.5D封装技术,在大多数情况下,是将不同类型的芯片并排水平组装。
消息人士称,三星的一些新技术,包括SAINT S,已经通过了验证测试。然而,三星将在与客户进行进一步测试后,于明年推出其商业服务。

三星2.5D H-Cube芯片封装解决方案
.
封装是半导体制造的最后一步,将芯片放置在保护壳中以防止腐蚀,并提供接口以组合和连接已制造的芯片。
台积电、三星和英特尔等领先的芯片制造商正在激烈竞争先进的封装技术,这种技术可以集成不同的半导体或垂直互连多个芯片。先进的封装技术允许将多个设备合并并封装为单个电子设备。
封装技术可以提高半导体性能,而无需通过超精细加工来缩小纳米尺寸,这具有技术挑战性,需要更多时间。
根据咨询公司 Yole Intelligence 的数据,全球先进芯片封装市场预计将从 2022 年的 443 亿美元增长到 2027 年的 660 亿美元。在 660 亿美元中,3D 封装预计将占约四分之一,即 150 亿美元。
台积电,目前3D封装领域的领导者
该技术一直在迅速增长,与生成式人工智能(如ChatGPT)的增长保持一致,这需要能够快速处理大量数据的半导体。

台积电是芯片封装技术的行业领导者
目前该行业的主流是2.5D封装,它使芯片尽可能靠近,以减少数据瓶颈。
全球第一大合同芯片制造商台积电也是全球先进封装市场的领导者,拥有十年历史的2.5D封装技术。
台积电正在为其客户测试和升级其3D芯片间堆叠技术SoIC,包括苹果股份有限公司和英伟达公司。台积电7月表示,将投资900亿台币(29亿美元)建设一家新的国内先进封装厂。
本月早些时候,全球第三大晶圆代工企业台湾联合微电子公司(UMC)启动了晶圆对晶圆(W2W)3D IC项目,为客户提供使用硅堆叠技术高效集成存储器和处理器的尖端解决方案。
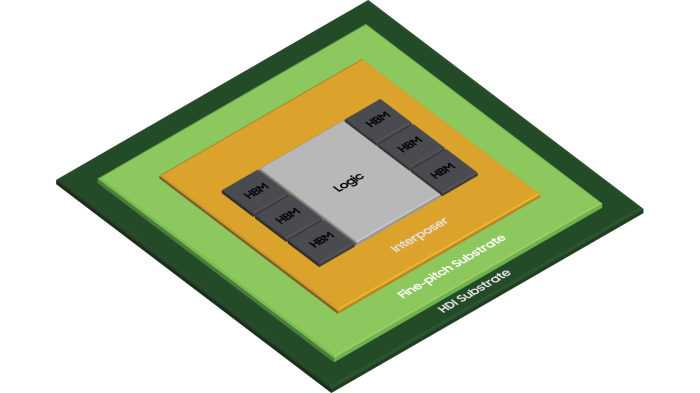
三星2.5D H-Cube芯片封装解决方案
联电表示,其与ASE、华邦电子、法拉第和Cadence Design Systems等封装公司合作的W2W 3D IC项目是一项雄心勃勃的事业,旨在利用3D芯片集成技术满足边缘AI应用的特定要求。
英特尔使用其下一代3D芯片封装技术Foveros来制造先进的芯片。
三星芯片封装路线图
自2021年推出2.5D封装技术H-Cube以来,全球第二大代工公司三星一直在加速其芯片封装技术的发展。
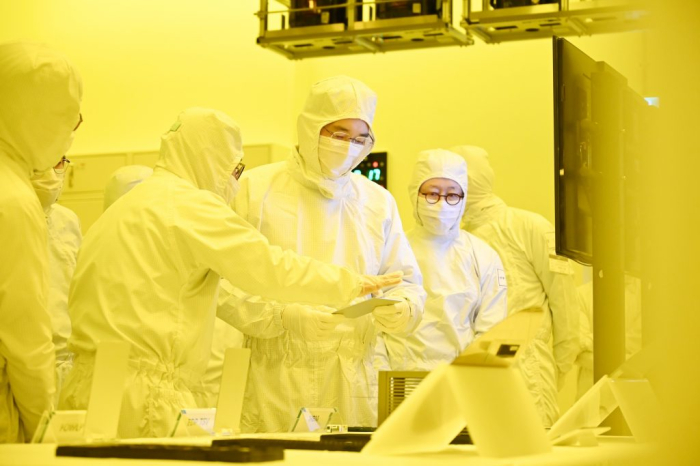
2023年2月17日,三星董事长李在镕(左三)参观三星在韩国的芯片封装生产线
三星表示,2.5D封装技术允许逻辑芯片或高带宽存储器(HBM)以小尺寸堆叠在硅中介层上。
这家韩国公司4月份表示,它正在提供包装交钥匙服务,处理从芯片生产到包装和测试的整个过程。
消息人士称,三星采用新的SAINT技术,旨在提高数据中心和具有设备上AI功能的移动AP的人工智能芯片的性能。












评论